
エリプソメータは、半導体やディスプレイ分野をはじめ、様々な分野で幅広く使用されています。Siやガラス基板上などに成膜された透明または半透明薄膜(酸化膜、窒化膜、レジスト、ITO など) の膜厚、光学定数(屈折率、消衰係数)の測定により、半導体ではリソグラフィ分野でのレジスト膜分布、デイスプレイでは有機ELパネルの有機膜評価などが挙げられます。
エリプソメトリ(偏光解析法)を利用し、光の偏光状態の変化から薄膜の膜厚や光学定数を解析します。ある一定の偏光状態となった光をサンプル表面に入射すると、膜の表面と基板の表面から反射した光の合成光は、薄膜が有ることにより入射した光と位相や振幅が変化します。この位相の変化をデルタ(Δ)、振幅比をプサイ(ψ)と呼び、エリプソメータはこの2つを測定し膜厚や屈折率を求めます。
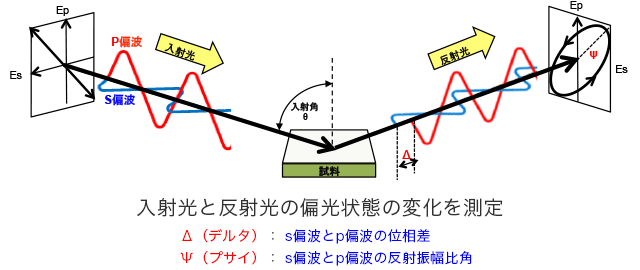
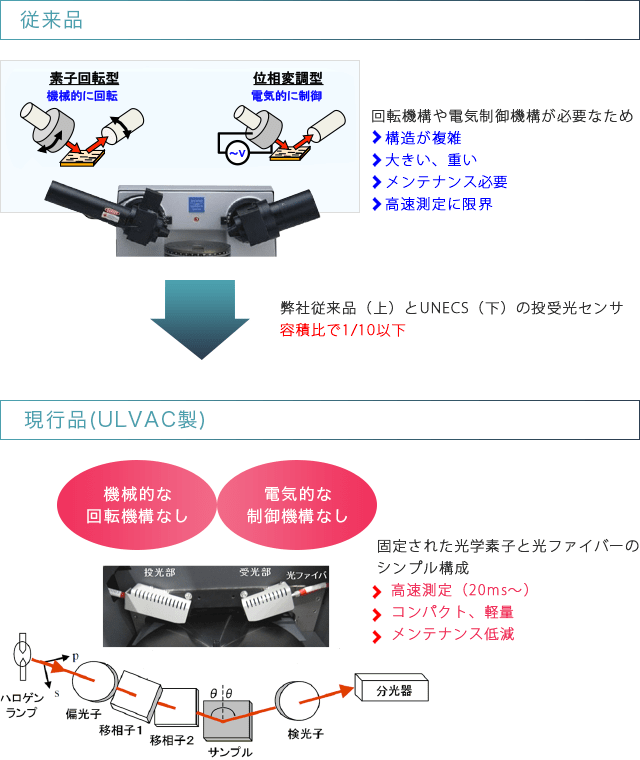
アルバックの高速分光エリプソメータ(UNECSシリーズ)は、薄膜の膜厚や屈折率を高速・高精度に測定します。独特な測定方式を採用し、高速測定とコンパクト化を実現しています。ユニークなポータブルタイプをはじめ、自動ステージタイプや真空環境に対応した装置への組み込みが可能なビルトインタイプまで用途に応じた幅広いラインアップを揃えています。

- ■高速測定
- 回転機構を持たない独特な測定方式により、最速20msの高速測定を実現
繰り返し測定や多ポイントの分布測定などが短時間で計測可能 - ■可視分光対応
- 波長範囲は、標準タイプ(530nm-750nm)の他、可視分光タイプ(380nm-760nm)も加わり、より幅広い用途に対応
- ■コンパクトなセンサユニット
- 投受光センサは、回転機構を持たない光学素子のみで構成し、非常に軽量・コンパクトで、定期的なメンテナンスは不要
- ■豊富なラインアップ
- ユニークなポータブルタイプをはじめ、手動/自動ステージタイプや大型基板タイプ、大気/真空環境に対応した装置ビルトインタイプなど、多様な用途に対応可能
| タイプ:ポータブル | |||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|
|
|
|||||||||||
| 型式 (ステージタイプ) |
波長範囲(nm) | スポット径(mm) | Zフォーカス | 追加機能 | |||||||
| 530-750 | 380-760 | 1 | 0.3 | 手動 | 自動 | 高精度 マップ 2000点 |
3D表示 | 観察 カメラ |
|||
| UNECS-Portable (固定タイプ) |
○ | – | ○ | – | ○ | – | – | – | – | ||
| UNECS-Portable-030 (固定タイプ) |
○ | – | – | ○ | ○ | – | – | – | – | ||
| UNECS-PortableW (固定タイプ) |
– | ○ | ○ | – | ○ | – | – | – | – | ||
| UNECS-PortableW-300 (固定タイプ) |
– | ○ | – | ○ | ○ | – | – | – | – | ||
| タイプ:手動ステージ | |||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|
 |
|||||||||||
| 型式M (ステージタイプ) |
波長範囲(nm) | スポット径(mm) | Zフォーカス | 追加機能 | |||||||
| 530-750 | 380-760 | 1 | 0.3 | 手動 | 自動 | 高精度 マップ 2000点 |
3D表示 | 観察 カメラ |
|||
| UNECS-1500M (手動φ150mm) |
○ | – | ○ | – | ○ | – | – | – | – | ||
| UNECS-1500M-030 (手動φ150mm) |
○ | – | – | ○ | ○ | – | – | – | – | ||
| UNECS-1500MW (手動φ150mm) |
– | ○ | ○ | – | ○ | – | – | – | – | ||
| UNECS-1500MW-030 (手動φ150mm) |
– | ○ | – | ○ | ○ | – | – | – | – | ||
| タイプ:自動ステージ | |||||||||||
|---|---|---|---|---|---|---|---|---|---|---|---|
 |
|||||||||||
| 型式 (ステージタイプ) |
波長範囲(nm) | スポット径(mm) | Zフォーカス | 追加機能 | |||||||
| 530-750 | 380-760 | 1 | 0.3 | 手動 | 自動 | 高精度 マップ 2000点 |
3D表示 | 観察 カメラ |
|||
| UNECS-1500A (自動φ150mm) |
○ | – | ○ | – | – | ○ | △ | △ | △ | ||
| UNECS-1500A-030 (自動φ150mm) |
○ | – | – | ○ | – | ○ | △ | △ | △ | ||
| UNECS-1500AW (自動φ150mm) |
– | ○ | ○ | – | – | ○ | △ | △ | △ | ||
| UNECS-1500AW-030 (自動φ150mm) |
– | ○ | – | ○ | – | ○ | △ | △ | △ | ||
| UNECS-2000A (自動φ200mm) |
○ | – | ○ | – | – | ○ | △ | △ | △ | ||
| UNECS-2000A-030 (自動φ200mm) |
○ | – | – | ○ | – | ○ | △ | △ | △ | ||
| UNECS-2000AW (自動φ200mm) |
– | ○ | ○ | – | – | ○ | △ | △ | △ | ||
| UNECS-2000AW-030 (自動φ200mm) |
– | ○ | – | ○ | – | ○ | △ | △ | △ | ||
| UNECS-3000A (自動φ300mm) |
○ | – | ○ | – | – | ○ | ○ | △ | △ | ||
| UNECS-3000A-030 (自動φ300mm) |
○ | – | – | ○ | – | ○ | ○ | △ | △ | ||
| UNECS-3000AW (自動φ300mm) |
– | ○ | ○ | – | – | ○ | ○ | △ | △ | ||
| UNECS-3000AW-030 (自動φ300mm) |
– | ○ | – | ○ | – | ○ | ○ | △ | △ | ||
| タイプ:ビルトイン | ||||||
|---|---|---|---|---|---|---|
 |
||||||
| 型式 | 用途 | 波長範囲(nm) | スポット径(mm) | |||
| 大気 | 真空 | 530-750 | 380-760 | 1 | 0.3 | |
| UNECS-1M | ○ | – | ○ | – | ○ | – |
| UNECS-1M-030 | ○ | – | ○ | – | – | ○ |
| UNECS-1MW | ○ | – | – | ○ | ○ | – |
| UNECS-1MW-030 | ○ | – | – | ○ | – | ○ |
| UNECS-1MV | – | ○ | ○ | – | ○ | – |
| UNECS-1MVW | – | ○ | – | ○ | ○ | – |
-
ポータブル
測定部の重量はわずか2.2kgで持ち運びも出来るポータブルタイプです。
-
高速測定
最速20msの高速測定を実現、素早く測定・解析ができます。
-
波長選択
標準タイプ530〜750nm、可視分光タイプ380〜760nmより選択できます。
-
スポット径選択
Φ1mmまたはΦ0.3mmより選択できます。

-
手動ステージ
操作性に優れたΦ150mm R-θステージで測定位置決めが容易です。
-
高速測定
最速20msの高速測定を実現、素早く測定・解析ができます。
-
波長選択
標準タイプ530〜750nm、可視分光タイプ380〜760nmより選択できます。
-
スポット径選択
Φ1mmまたはΦ0.3mmより選択できます。
- ■測定解析
- 簡単に測定・解析が行えるシンプルな構成
測定・フィッテイング結果も瞬時に解析・表示 -
150-300mm対応
Φ150,200,300mmの3機種から選択できます。
-
自動ステージ・
オートフォーカス自動ステージとオートフォーカス機能により基板面内の膜厚分布を素早く自動測定し、結果をカラーマップ表示します。
-
高速測定
最速20msの高速測定を実現、素早く測定・解析ができます。
-
波長選択
標準タイプ530〜750nm、可視分光タイプ380〜760nmより選択できます。
-
スポット径選択
Φ1mmまたはΦ0.3mmより選択できます。
- ■測定解析
- R-θ式自動ステージを搭載、自動マッピング測定
基板をセットしてスタートボタンを押せば、オートフォーカス(高さ自動調整)→指定座標測定→フィッティング解析→基板アンロードまで自動検知します。 - 測定座標はR-Θ(半径と角度)とX,Y(前後・左右)の2通りで入力できます。(最大で200ポイント)
- 測定結果はリアルタイムに表示されます。
- 測定結果(ψプサイ、Δデルタの波長範囲での分布グラフ)がリアルタイム表示されます。後から再解析も可能です。
-
ビルトイン
軽量・コンパクトなセンサユニットにより、成膜装置などへの組み込みが容易に行なえます。
-
高速測定
最速20msの高速測定を実現、素早く測定・解析ができます。
-
波長選択
標準タイプ530〜750nm、可視分光タイプ380〜760nmより選択できます。
-
スポット径選択
Φ1mmまたはΦ0.3mmより選択できます。
-
真空対応
通常の大気タイプのほか、真空環境に対応した真空タイプも用意しています。
- ■自動マッピング測定
- 高速マッピング測定で膜厚分布を短時間で評価可能
測定座標の入力はX,Yモードまたは R-θモードにて簡単に指定可能 - 材料ごとの光学定数(屈折率や消衰係数)を収納したマテリアルテーブルファイルをユーザが自由に編集追加することができます。
- 主要な材料の文献値は、あらかじめライブラリに収納。これ以外の材料や未知の材料を評価する場合、または文献値ではうまく解析できない場合などは、実測したデータを元にファイルの内容を編集をしたり、新たに追加することが簡単にできます。
これにより信頼性の高い解析が可能となりました。 - 多くのマテリアルデータファイルは、非公開(ユーザでは編集不可)としているため、都度メーカに編集・解析を依頼し、時間が必要となります。基本的に有償が多く、未知の材料を扱うR&Dでの不便な状況を解消します。





シンプルで使いやすいソフトウェアで誰にでも高精度な分布測定が行えます。

高速測定と、優れた測定再現性を両立
測定が早くても、データの信頼性は低下しません。多くの(他社)同等製品と比べ、格段に安定した再現性が得られます。

| 測定 | 膜厚(nm) | 屈折率(633nm) |
|---|---|---|
| 1 | 205.6 | 1.459 |
| 2 | 205.7 | 1.459 |
| 3 | 205.5 | 1.458 |
| 4 | 205.6 | 1.459 |
| 5 | 205.5 | 1.459 |
| 6 | 205.6 | 1.459 |
| 7 | 205.6 | 1.459 |
| 8 | 205.7 | 1.458 |
| 9 | 205.6 | 1.459 |
| 10 | 205.6 | 1.458 |
| 平均値 | 205.6 | 1.459 |
| 最大値 | 205.7 | 1.459 |
| 最小値 | 205.5 | 1.458 |
| 標準偏差 | 0.050 | 0.0003 |
| 標準偏差(%) | 0.02% | 0.02% |

膜や基板の光学定数を納めたマテリアルテーブルファイルは公開しているので、ユーザ側で自由に追加や編集ができます。実際の膜質に近いデータを構築していくことで、より信頼性の高い解析が行えます。
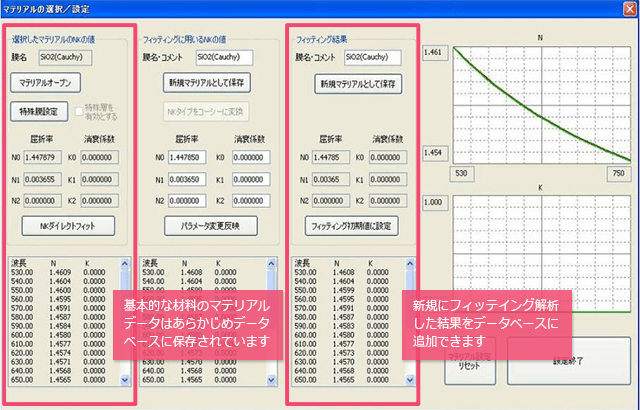
![]()
1. 有機EL:Alq3/ガラス 単層膜

4サンプルで膜厚と屈折率を測定し、膜厚は触針式段差計と非常に高い相関が取れます。
| サンプル | A | B | C | D | ||||
|---|---|---|---|---|---|---|---|---|
| 測定対象 | 屈折率 | 膜厚 | 屈折率 | 膜厚 | 屈折率 | 膜厚 | 屈折率 | 膜厚 |
| N | D(nm) | N | D(nm) | N | D(nm) | N | D(nm) | |
| UNECS測定値 | 1.712 | 118.5 | 1.728 | 115.8 | 1.731 | 115.0 | 1.729 | 112.1 |
| 触針式段差計 | - | 118.4 | - | 111.8 | - | 116.1 | - | 109.3 |
2. 薄膜太陽電池:SiO2/μc-Si/ガラス 2層膜

20nm程度のSiO2薄膜も問題なく測定。トータル膜厚(SiO2+μc-Si)では触針式段差計と非常に高い相関が得られます。
| サンプル | A | B | C | ||||||
|---|---|---|---|---|---|---|---|---|---|
| 測定膜 | μc-Si | SiO2 | μc-Si+ SiO2 |
μc-Si | SiO2 | μc-Si+ SiO2 |
μc-Si | SiO2 | μc-Si+ SiO2 |
| UNECS測定値 | 509.9 | 18.2 | 528.1 | 523.2 | 13.8 | 537.0 | 518.8 | 21.7 | 540.4 |
| 触針式段差計 | - | - | 525.4 | - | - | 541.4 | - | - | 546.3 |
3. SiO2単層膜
2nm程度の薄膜でも再現性(繰り返し性)は良好です。

| 計測値 *1) | 繰返し性σ | |
|---|---|---|
| SiO2膜厚 | 1.96 nm | 0.03 nm |
4. レジスト単層膜(膜厚・屈折率同時測定)
2nm程度の薄膜でも再現性(繰り返し性)は良好です。

| 計測値 *1) | 繰返し性σ | |
|---|---|---|
| レジスト膜厚 (設計膜厚50nm) | 50.95 nm | 0.05 nm |
| レジスト屈折率 *2) | 1.576 | 0.02 |
5. レジスト / BARC 2層膜

| 計測値 *1) | 繰返し性σ | |
|---|---|---|
| レジスト膜厚 (設計膜厚50nm) | 48.17 nm | 0.72 nm |
| BARC膜厚(設計膜厚65nm) | 67.16 nm | 0.76 nm |
6. レジスト 3層膜(膜厚・屈折率同時測定)
最上層トップコートの膜厚・屈折率を同時測定しています。

| 計測値 *1) | 繰返し性σ | |
|---|---|---|
| トップコート膜厚 (設計膜厚30nm) | 28.79 nm | 0.05 nm |
| トップコート屈折率 *2) | 1.342 | 0.001 |
7. ALD成膜 HfO2(酸化ハフニウム)極薄膜
測定したウェーハ中心付近のHfO2膜厚(5.85nm、2.46nm)は、TEM(透過型電子顕微鏡)での測定値(6.0nm、2.5nm)とほぼ一致しました。(UNECSの測定信頼性が確認できました)
【測定モデル】
| 膜種 | |
|---|---|
| 最上層 | HfO2 |
| 中間層 | SiO2 |
| 基板 | Siウェーハ |
【測定結果】
| サンプル | 膜厚 | 中心近辺の膜厚 (nm) |
|||
|---|---|---|---|---|---|
| 最大値 (nm) |
最小値 (nm) |
平均値 (nm) |
均一性 (%) |
||
| 5nm Hfo2/自然酸化膜/Si基板 | 6.12 | 5.63 | 5.83 | 4.2% | 5.85 |
| 2nm Hfo2/自然酸化膜/Si基板 | 2.56 | 2.37 | 2.45 | 3.9% | 2.46 |











